充実の解析体制
ジャパンセミコンダクターの解析技術

故障箇所特定から物理解析まで一貫して対応可能な体制があり、物理解析は24h体制で実行しています。また、物理解析の結果から故障メカニズムの推定も行っています。
品質サポート体制
国内トップの車載メ−カ−(エンジン/ブレ−キ用)をはじめ、主要大手企業との長年の取引により信頼を構築してまいりました。
- クレ−ム対応:3日以内に一次回答、10日以内に最終回答(TAT3/TAT10)
※クレーム対応日数は目標値であり、回答日は案件毎に決定されます。 - 品質資料/評価サンプル
- 1. 技術/品質/製造 一貫体制で御要求に 対応したJIT(Just in time)を達成
- 2. 充実した評価/解析ツ−ルを整備
故障解析フロー
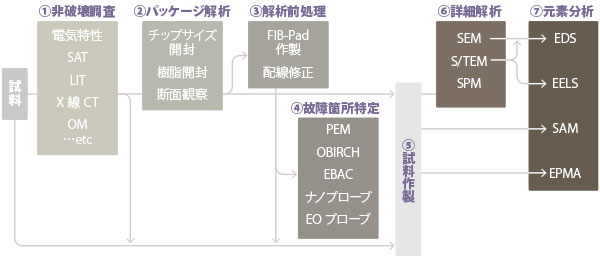
故障原因究明のために、電気特性・非破壊調査を行い故障状況を詳細に把握します。解析作業の前に、最適手法を検討し解析を進めます。
解析技術
1. 非破壊調査
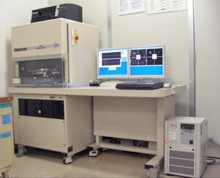
- SAT:超音波探傷装置
- パッケージ内部の状態を観察し、剥離やクラックなどを確認します。リファレンス品と比較して判断する場合もあります。(剥離/Void検出)

- X線CT: X線CT透過装置
- パッケージの状態でフレーム間異物、ボンディングワイヤーの形状、ペーストの濡れ性などを確認します。(Wire/Frame異常)

- TDR:時間領域反射率測定装置
- 不良が予想される基板またはパッケージの電極にプローブし高速パルス信号を入力し、その反射信号を観測、良品と比較することで、不良を確認します。(基盤内Open/Short)
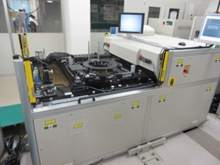
- LIT:発熱解析装置
- 実装基板やIC-PKGに信号を入力し、不良箇所からの発熱をサーマル顕微鏡を使って観察します。(DC故障部位確認)
2. 故障特定技術

- テスターリンク故障箇所特定
- テストヘッドとPEM/EOP解析装置をドッキングさせ、製品を動作状態で不良箇所の特定を行います。テスターはi-FLEX/T6573の2台です。ウェーハ/パッケージ/単体チップに対応しています。
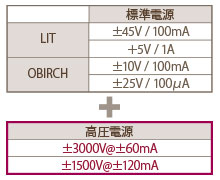
- 高圧電源観察
- OBIRCH/LIT装置は、標準電源に加えて、高圧仕様の電源を用意しており、±750V(安全対策済)で観察が可能です。
3. 回路修正/Pad作製サービス
FIB装置による、配線の切離し、配線接続などの回路修正が可能です。また、パッシベーション上にPadの作製も行っています。
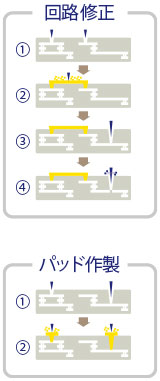
- 工程
- 1. 接続対象配線を露出
(絶縁膜ミリング用ガスを使用) - 2. 2つの配線を接続
(導体デポジションガスを使用) - 3. 切断対象配線を露出
(絶縁膜ミリング用ガスを使用) - 4. 露出した配線を切断
(メタルミリング用ガスを使用)
- 1. 接続対象配線を露出
- 工程
- 1. 対象配線を露出
(絶縁膜ミリング用ガスを使用) - 2. 導体を埋込、パッドを形成
(導体デポジションガスを使用)
- 1. 対象配線を露出
- Cu配線,Low-k膜に対応
- 各種パッケージ、ウェーハ(6,8インチ)、チップ状態での加工に対応
- CADデータ(GDS II フォーマット)を使用した加工位置へのナビゲーション
- ICパッケージ開封,ポリイミド剥離などの前処理からFIB加工まで一貫した作業を請負可能








































